 |
Резонансно-туннельный диод.
|
|
|
|

В общем случае резонансно-туннельный диод представляет собой периодическую структуру, которая состоит из последовательно расположенных квантовых колодцев, разделенных потенциальными барьерами, с электрическими контактами к двум крайним противоположным областям. Чаще всего это двухбарьерные структуры с одним квантовым колодцем и симметричными характеристиками барьеров, поскольку по мере увеличения количества колодцев все труднее реализовать условия для согласованного резонансного переноса носителей заряда. 
Рис. 5 - Условное обозначение резонансно-туннельного диода (а), его эквивалентная схема (б), вольт-амперная и вольт-фарадная характеристики (в).
Емкость является чрезвычайно важной при определении быстродействия прибора. За исключением области напряжения вблизи токового резонанса она приблизительно равна емкости, рассчитанной для нелегированного разделительного слоя и обедненного слоя прибора. Пик емкости в области отрицательного дифференциального сопротивления обусловлен резонансными электронами, накопленными в яме.
Основной особенностью резонансно-туннельных диодов является наличие на его вольт-амперной характеристике области отрицательного дифференциального сопротивления, которая является основой для большинства его практических применений. Наиболее важные электрические параметры: пиковое значение плотности тока (peak current density) и пиковое напряжение (peak voltage) – напряжение в области пика плотности тока, долинная плотность тока в минимуме (valley current density), отношение этих плотностей тока (peak-to-valley ratio).
Псевдоморфные и метаморфные гетероструктуры. Правило Вегарда.
Транзистор с высокой подвижностью электронов (HEMT) — полевой транзистор, в котором для создания канала используется контакт двух полупроводниковых материалов с различной шириной запрещенной зоны (вместо легированной области как у обычных МОП-транзисторов). В отечественной и зарубежной литературе такие приборы часто обозначают HEMT — от англ. High Electron Mobility Transistor. Также в зависимости от структуры используются аналогичные названия: HFET, HEMFET, MODFET, TEGFET, SDHT. Другие названия этих транзисторов: полевые транзисторы с управляющим переходом металл — полупроводник и гетеропереходом, ГМеП транзисторы, полевые транзисторы с модулированным легированием, селективно-легированные гетероструктурные транзисторы (СЛГТ).
|
|
|
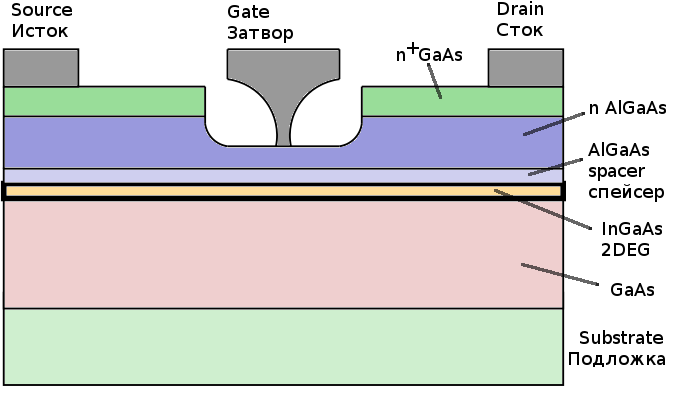
Структура HEMT транзистора.
Псевдоморфный.
ТВПЭ, в котором правило соответствия параметра кристаллической решётки слоёв гетероперехода не соблюдается, называется псевдоморфным (пТВПЭ или pHEMT). Для этого слой одного из материалов делается очень тонким — настолько, что его кристаллическая решётка попросту растягивается до соответствия другому материалу. Такой способ позволяет изготавливать структуры с увеличенной разницей в ширине запрещенной зоны, что недостижимо другими путями. Такие приборы обладают улучшенной производительностью.
Возможный способ адаптации полупроводниковых структур с разными параметрами кристаллической решетки состоит в том, чтобы создать условия, в которых кристаллическая решетка одного из компонентов гетероструктуры сожмется или растянется до необходимой величины. Для этого слой одного из материалов делается очень тонким — настолько, что его кристаллическая решётка изменяется и приходит в соответствие другому материалу. Гетеропереход, в котором правило соответствия параметров кристаллической решётки слоёв гетероперехода не соблюдается, называется псевдоморфным гетеропереходом. C использованием псевдоморфных переходов можно изготавливать гетероструктуры с увеличенной разницей в ширине запрещенной зоны, что недостижимо другими путями.
|
|
|
Метаморфный.
Другой способ совмещения материалов с разными решётками — помещение между ними буферного слоя. Это применяется в метаморфном ТВПЭ (мТВПЭ или mHEMT). Буферный слой представляет собой AlInAs, с концентрацией индия подобранной таким образом, что решётка буферного слоя может быть согласована как подложкой GaAs, так и с каналом InGaAs. Преимуществом такой структуры является возможность выбора практически любой концентрации индия для создания канала, то есть прибор может быть оптимизирован для различных применений (низкая концентрация индия обеспечивает низкий шум, а высокая — бо́льшую степень усиления).
Еще один способ совмещения материалов с разными решётками — помещение между ними буферного слоя. Материал буферного слоя подбирается таким образом, чтобы его решетка могла быть согласована как с одним, так и с другим материалами гетероперехода. Такие структуры принято называть метаморфными гетеропереходами.
Правило Вегарда.
Апроксимированное эмпирическое правило, которое гласит, что существует линейная зависимость при постоянной температуре между свойствами кристаллической решётки сплава и концентрацией отдельных его элементов.
Таким образом, параметры кристаллической решётки ( ) твёрдого раствора (сплава) материалов с одинаковой структурой решётки, могут быть найдены путём линейной интерполяции между параметрами решётки исходных соединений, например для твёрдых растворов SixGe1-x и InPxAs1-x:
) твёрдого раствора (сплава) материалов с одинаковой структурой решётки, могут быть найдены путём линейной интерполяции между параметрами решётки исходных соединений, например для твёрдых растворов SixGe1-x и InPxAs1-x:

 .
.
Можно также расширить это соотношение для определения энергии запрещенной зоны полупроводника. Используя, как и в предыдущем случае, InPxAs1-x, можно найти выражение, которое описывает зависимость энергии запрещенной зоны полупроводника  от соотношения её составляющих и параметра
от соотношения её составляющих и параметра  где
где  -параметр прогиба(нелинейности), имеющий тем большее значение, чем сильнее различие периодов решёток компонентов:
-параметр прогиба(нелинейности), имеющий тем большее значение, чем сильнее различие периодов решёток компонентов:

Модулированное легирование и транзисторы с высокой подвижностью электронов (НЕМТ).
Транзистор с высокой подвижностью электронов (ТВПЭ, HEMT) — полевой транзистор, в котором для создания канала используется контакт двух полупроводниковых материалов с различной шириной запрещенной зоны (вместо легированной области как у обычных МОП-транзисторов).
|
|
|
На рисунке представлена структура HEMT-транзистора в разрезе. На полуизолирующей подложке арсенида галлия (GaAs) выращивается нелегированный буферный слой GaAs. На нем наращивается тонкий слой полупроводника с иной шириной запрещенной зоны — InGaAs, такой, что образуется область двумерного электронного газа (2DEG). Сверху слой защищается тонким спейсером на основе арсенида алюминия-галлия AlxGa1−xAs (далее AlGaAs). Выше следуют легированный кремнием слой n-AlGaAs и сильнолегированный слой n+-GaAs под контактными площадками стока и истока. Контакт затвора приближен к области двумерного электронного газа.

В общем случае, для создания проводимости в полупроводниках используются легирующие примеси. Однако, получаемые электроны проводимости испытывают столкновения с примесными остовами, что отрицательно сказывается на подвижности носителей и быстродействии прибора. В ТВПЭ этого удается избежать за счет того, что электроны с высокой подвижностью генерируются на гетеропереходе в области контакта высоколегированного донорного слоя N-типа с широкой запрещенной зоной (в нашем примере AlGaAs) и нелегированного канального слоя с узкой запрещенной зоной без каких-либо легирующих примесей (в данном случае GaAs).
Электроны, образующиеся в тонком слое N-типа, полностью перемещаются в слой GaAs, обедняя слой AlGaAs. Обеднение происходит из-за изгиба потенциального рельефа в гетеропереходе — между полупроводниками с разной шириной запрещенной зоны образуется квантовая яма. Таким образом, электроны способны быстро передвигаться без столкновений с примесями в нелегированном слое GaAs. Образуется очень тонкая прослойка с большой концентрацией высокоподвижных электронов, обладающих свойствами двумерного электронного газа (ДЭГ). Сопротивление канала очень низкое, и подвижность носителей в нём высока.
Так же, как в других типах полевых транзисторов, приложенное к затвору ТВПЭ напряжение изменяет проводимость канального слоя.
|
|
|
Принцип действия ТВПЭ — аналогичен принципу действия МеП-транзистора. Между металлическим затвором и расположенным под ним слоем из AlGaAs, образуется управляющий переход Металл - Полупроводник (далее по тексту Ме — п/п). Обедненная область этого перехода располагается, в основном, в слоях AlGaAs. Канал нормально открытого транзистора при  формируется в слое нелегированного GaAs на границе гетероперехода в области накопления двумерного электронного газа. Под действием управляющего напряжения
формируется в слое нелегированного GaAs на границе гетероперехода в области накопления двумерного электронного газа. Под действием управляющего напряжения  изменяется толщина обедненной области перехода Ме — п/п, концентрация электронов в ДЭГ и ток стока. Электроны поступают в область накопления из истока. При достаточно большом (по модулю) отрицательном
изменяется толщина обедненной области перехода Ме — п/п, концентрация электронов в ДЭГ и ток стока. Электроны поступают в область накопления из истока. При достаточно большом (по модулю) отрицательном  обедненная область расширяется настолько, что перекрывает область насыщения электронов. Ток стока при этом прекращается.
обедненная область расширяется настолько, что перекрывает область насыщения электронов. Ток стока при этом прекращается.
В нормально закрытом транзисторе вследствие меньшей толщины верхнего слоя AlGaAs при  проводящий канал отсутствует, так как область насыщения двумерного электронного газа перекрыта обедненной областью управляющего перехода. Канал возникает при некотором положительном
проводящий канал отсутствует, так как область насыщения двумерного электронного газа перекрыта обедненной областью управляющего перехода. Канал возникает при некотором положительном  , когда обедненная область управляющего перехода сужается настолько, что её нижняя граница попадает в область накопления электронов.
, когда обедненная область управляющего перехода сужается настолько, что её нижняя граница попадает в область накопления электронов.
|
|
|


