 |
Методы термохимии. (Пиролиз и эпитаксия)
|
|
|
|
Пиролиз силанов используют в планарной технологии на кремнии для получения толстых слоев оксида при низких температурах, когда термическое окисление неприменимо из-за существенного изменения параметров диффузионных слоев при температурах окисления. Такие слои необходимы для специальных типов транзисторов, для уменьшения суммарной емкости коллектора, значительный вклад в которую вносит емкость контактных площадок, расположенных на оксиде.
Наиболее часто используют два метода:
- пиролиз в потоке газа-носителя;
- вакуумный пиролиз.
При пиролизе в потоке газа газ-носитель проходя через барботер, захватывает пары силана и поступает в реакционную камеру, представляющую собой кварцевую трубу, помещенную в печь с температурой, достаточной для разложения силана. Обычно используют тетраэтоксилан, разлагающийся при 7000 С. При разложении образуется оксид кремния, который осаждается на помещенные в рабочую зону печи кремниевые пластины. Этот метод дает наиболее жесткие по структуре слои, однако не очень критичен к подбору скорости газа-носителя, конструкции держателей пластин и самой системы (довольно трудно получить ламенеарный поток без завихрений, дающий равномерные пленки по всей площади окисления). Кроме того, зона, в которой разложение силана не приводит к еще заметному снижению его концентрации в потоке, обычно меньше зоны с постоянной температурой в нем, а увеличение этой зоны за счет большой скорости потока также приводит к неравномерности пленок по толщине из-за появления завихрений удержателя с пластинами.
В тех случаях когда, равномерность слоя оксида по толщине является главным требованием, применяют вакуумный пиролиз. Система получения слоев при вакуумном пиролизе аналогична рассмотренной, разница лишь в том, что реакционная камера откачивается, а пары силана в контролируемой остаточной атмосфере подаются в систему через обтекатель, при этом пары равномерно распределяются по всему объему реакционной камеры и дают равномерное осаждение в зоне с постоянной температурой. Трудность метода состоит в создании контролируемой атмосферы в откачиваемом объеме. Появление неконтролируемых загрязнений резко ухудшает качество, получаемых этим методом, слоев.
|
|
|
Эпитаксией называют процесс наращивания монокристаллических слоев на подложку, при котором кристаллографическая ориентация наращиваемого слоя повторяет кристаллографическую ориентацию подложки.
В настоящее время эпитаксия обычно используется для получения тонких рабочих слоев однородного полупроводника на сравнительно толстой подложке, играющей роль несущей конструкции.
Типовой — хлоридный процесс эпитаксии применительно к кремнию состоит в следующем (рис. 6.2). Монокристаллические кремниевые пластины загружают в тигель «лодочку» и помещают в кварцевую трубу. Через трубу пропускают поток водорода, содержащий небольшую примесь тетрахлорида кремния SiCl4. При высокой температуре (около 1200 °С), которая обеспечивается высокочастотным нагревом тигля, на поверхности пластин происходит реакция
SiCl4 + 2Н2 = Si + 4HCl.
В результате реакции на подложке постепенно осаждается слой чистого кремния, а пары НС1 уносятся потоком водорода. Эпитаксиальный слой осажденного кремния монокристалличен и имеет ту же кристаллографическую ориентацию, что и подложка. Химическая реакция, благодаря подбору температуры, происходит только на поверхности пластины, а не в окружающем пространстве.

Рис. 6.2. Схема хлоридного процесса эпитаксии: 1 — кварцевая труба; 2 — катушка ВЧ нагрева; 3 — тигель с пластинами; 4 — пластина кремния; 5 — вентиль для перекрытия соответствующего газа; в — измеритель скорости потока
|
|
|
Процесс, проходящий в потоке газа, называют газотранспортной реакцией, а основной газ (в данном случае водород), переносящий примесь в зону реакции, — газом-носителем.
Если к парам тетрахлорида кремния добавить пары соединений бора (В2Н6) или фосфора (РН3), то эпитаксиальный слой будет иметь уже не собственную, а соответственно дырочную или электронную проводимость, поскольку в ходе реакции в осаждающийся кремний будут внедряться акцепторные атомы бора или донорные атомы фосфора.
В установке, показанной на рис. 6.2, предусмотрены некоторые дополнительные операции: продувка трубы азотом и неглубокое травление поверхности кремния в парах НСl (с целью очистки). Эти операции проводятся до основных.
Таким образом, эпитаксия позволяет выращивать монокристаллические слои любого типа проводимости и любого удельного сопротивления на подложке, обладающей тоже любым типом и величиной проводимости (рис 6.3).
Эпитаксиальная пленка может отличаться от подложки по химическому составу. Способ получения таких пленок называют гетероэпитаксией, в отличие от гомоэпитаксии, описанной выше. Конечно, при гетероэпитаксии материалы пленки и подложки должны по-прежнему иметь одинаковую кристаллическую решетку. Например, можно выращивать кремниевую пленку на сапфировой подложке.
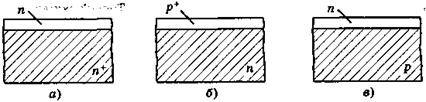
Рис. 6.3. Примеры эпитаксиальных структур:
а — пленка n-типа на n+-подложке; б — пленка р+-типа на n-подложке;
в — пленка n-типа на р-подложке
Граница между эпитаксиальным слоем и подложкой не получается идеально резкой, так как примеси в процессе эпитаксии частично диффундируют из одного слоя в другой. Это обстоятельство затрудняет создание сверхтонких (менее 1 мкм) и многослойных эпитаксиальных структур. Основную роль в настоящее время играет однослойная эпитаксия. Она существенно пополнила арсенал полупроводниковой технологии; получение таких тонких однородных слоев (1-10 мкм), какие обеспечивает эпитаксия, невозможно иными средствами.
|
|
|


