 |
Магнитная память произвольной адресации (MRAM - magnetic/magnetoresistive random access memory)
|
|
|
|
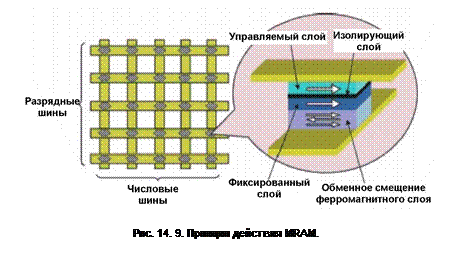 В настоящее время создается универсальная память, которая сочетает высокую скорость доступа, высокую плотность, неразрушаемость после выключения питания, которая базируется на субмикронных магнитных элементах. Это, т.н. MRAM, сочетающая свойства магнитной памяти на жестком диске и электронной памяти произвольной адресации RAM (Random Access Memory). Неразрушающаяся память становится все более востребованной с развитием мобильных средств хранения информации все увеличивающегося объема: ноутбуки, мобильные телефоны, различного рода персональные записные книжки и т.д. В такого рода устройствах требуется хранить информацию в течение ~10 лет. В отличие от флэш-памяти, MRAM обещает быть гораздо более быстродействующей (с циклом чтения и записи порядка нескольких наносекунд) и иметь очень малую склонность к деградации после большого числа записи/чтения. MRAM обещает также быть достаточно устойчивой к радиационным воздействиям, т.е. будет востребована в космических исследованиях и пригодна к военным приложениям. В наиболее оптимистичном сценарии, MRAM будет сочетать скорость статической RAM (SRAM) с плотностью динамической RAM (DRAM) и неразрушаемостью флэш-RAM, все это в одной технологии. Поэтому MRAM называют еще универсальной памятью. Наиболее простое удобство MRAM – не будет необходимости при включении компьютера ждать, когда он загрузится с жесткого диска.
В настоящее время создается универсальная память, которая сочетает высокую скорость доступа, высокую плотность, неразрушаемость после выключения питания, которая базируется на субмикронных магнитных элементах. Это, т.н. MRAM, сочетающая свойства магнитной памяти на жестком диске и электронной памяти произвольной адресации RAM (Random Access Memory). Неразрушающаяся память становится все более востребованной с развитием мобильных средств хранения информации все увеличивающегося объема: ноутбуки, мобильные телефоны, различного рода персональные записные книжки и т.д. В такого рода устройствах требуется хранить информацию в течение ~10 лет. В отличие от флэш-памяти, MRAM обещает быть гораздо более быстродействующей (с циклом чтения и записи порядка нескольких наносекунд) и иметь очень малую склонность к деградации после большого числа записи/чтения. MRAM обещает также быть достаточно устойчивой к радиационным воздействиям, т.е. будет востребована в космических исследованиях и пригодна к военным приложениям. В наиболее оптимистичном сценарии, MRAM будет сочетать скорость статической RAM (SRAM) с плотностью динамической RAM (DRAM) и неразрушаемостью флэш-RAM, все это в одной технологии. Поэтому MRAM называют еще универсальной памятью. Наиболее простое удобство MRAM – не будет необходимости при включении компьютера ждать, когда он загрузится с жесткого диска.
Принцип действия.
В MRAM, каждая ячейка может являться битом памяти и представлять собой субмикронный элемент ферромагнитного материала, обычно пермаллоя (Ni-Fe). Если этот элемент намагничен, скажем направо, рис. 14.9, то это будет соответствовать «1», если налево, то «0». Эти элементы расположены в виде квадратной сетки. Данные записываются путем пропускания тока через проводящие линии, расположенные выше и ниже этих элементов, называемых, соответственно, разрядными (bit lines) и числовыми (word lines) линиями (или шинами). Ток, протекающий по плоскому проводнику, генерирует магнитное поле, направленное в плоскости проводника перпендикулярно направлению тока. Т.е., ток, протекающий в направлении х, генерирует магнитное поле в направлении y, и наоборот. Чтобы произвести запись по определенному адресу используют магнитную анизотропию и гистерезис материала. Перемагничивание однодоменной частицы, как следует из рассмотрения в главе IX, происходит путем вращения вектора намагничения. Однодоменная модель Стонера-Волфарта предполагает неизменную длину вектора намагничения, пренебрегает тепловыми эффектами. Согласно этой модели угловая зависимость магнитного поля описывается зависимостью
|
|
|
H(φ) = H(0)[cos2/3φ + sin2/3φ]-2/3, (14.1)
где H(φ) – переключающее поле (т.е. напряженность магнитного поля, требуемая для записи), приложенное под углом φ к оси легкого намагничения и H(0) – переключающее поле при φ=0. Если полное внешнее поле складывается из х -компонеты, Нх, и y -компоненты, Hy, как в случае MRAM, где Нх обусловлено током числовой шины, а Hy – разрядной шины,
Нх2/.3 + Hy2/3 ≥ H(0)2/3. (14.2) Астроида, соответствующая (14.2), изображена на рис. 14.10. Отмечены области (Нх,Hy), где одного Нх или Hy недостаточно для перемагничения, и лишь одновременное воздействие приводит к записи либо «1», либо «0».
Чтение производится с помощью эффекта туннельного или гигантского магнетосопротивления (TMR или GMR), как обсуждалось в главе X и, дополнительно поясняется на рис. 14.11. Изолирующий слой между двумя ферромагнетиками делает невозможным классический ток, однако, при толщине в 1-2 нм, электроны могут туннелировать из одного слоя в другой. Это оказывается возможным лишь при условии, что состояния на уровне Ферми для спинов с данной ориентацией оказываются не заполненными.
|
|
|
 |  | ||
Присутствие магнитного поля приводит к перераспределению d-состояний. Электроны со спином, ориентированным вдоль поля имеют более низкую энергию, и зона оказывается заполненной. Т.е., при параллельной ориентации намагниченности в ферромагнитных слоях, спины могут туннелировать через разделяющий диэлектрический слой, а при антипараллельной ориентации – не могут. В реальности это означает увеличение сопротивления при антипараллельной ориентации намагниченности.
Технически, это реализуется путем фиксации намагничения в одном из ферромагнитных слоев за счет обменного взаимодействия на границе с антиферромагнитным слоем, рис. 14.9. Процесс считывания, принципиально прост. Достаточно приложить определенную разность потенциала к нужным шинам, как изображено на рис. 14.12. При этом, возможны утечки тока по соседним элементам, что усложняет анализ. Это одна из проблем, которые сейчас стоят на повестке для у разработчиков MRAM.
 Разработки MRAM интенсивно ведутся в IBM, и в ряде других фирм, таких как Siemens, Motorola, Philips, Hewlett Packard, и Hitachi. Еще в 2002 г. Motorola объявила о создании 1 Mb MRAM, который использует один транзистор и туннельный переход на ячейку [2]. Чип имеет конфигурацию 64 Kb х16. Используется 0.6 µm CMOS-технология на пластинах Ф200 мм с Cu соединениями. Циклы чтения и записи занимают менее чем 50 нс.
Разработки MRAM интенсивно ведутся в IBM, и в ряде других фирм, таких как Siemens, Motorola, Philips, Hewlett Packard, и Hitachi. Еще в 2002 г. Motorola объявила о создании 1 Mb MRAM, который использует один транзистор и туннельный переход на ячейку [2]. Чип имеет конфигурацию 64 Kb х16. Используется 0.6 µm CMOS-технология на пластинах Ф200 мм с Cu соединениями. Циклы чтения и записи занимают менее чем 50 нс.
|
|
|


