 |
Модель интегрального биполярного транзистора
|
|
|
|
На рис. 4.10 приведена модель интегрального транзистора типа n-р-n,аналогичная модели Эберса – Молла дискретного транзистора. Она учитывает, что в структуре интегрального транзистора кроме основного n-р-n транзистора имеется паразитный p-n-p транзистор (см. рис. 3.3).
Диоды VD1 – VD3моделируют свойства эмиттерного, коллекторного и изолирующего р-n переходов соответственно. Вольт-амперные характеристики этих диодов аппроксимируются формулами
 ,
,  ,
,  ,
,
где  ,
,  ,
,  – параметры модели, имеющие смысл тепловых обратных токов эмиттерного, коллекторного и изолирующего переходов. Положительными считаются токи
– параметры модели, имеющие смысл тепловых обратных токов эмиттерного, коллекторного и изолирующего переходов. Положительными считаются токи  ,
,  ,
,  , соответствующие прямым включениям переходов. Положительные направления токов во внешних выводах эмиттера, базы, коллектора и подложки показаны стрелками на рис. 4.10. Они совпадают с направлениями токов в активном режиме, как для основного, так и для паразитного транзисторов. Напряжения между внешними выводами эмиттер – база
, соответствующие прямым включениям переходов. Положительные направления токов во внешних выводах эмиттера, базы, коллектора и подложки показаны стрелками на рис. 4.10. Они совпадают с направлениями токов в активном режиме, как для основного, так и для паразитного транзисторов. Напряжения между внешними выводами эмиттер – база  , коллектор – база
, коллектор – база  , коллектор – подложка
, коллектор – подложка  и напряжения на р-п переходах
и напряжения на р-п переходах  ,
,  ,
,  считаются положительными, если соответствующий переход включен в прямом направлении.
считаются положительными, если соответствующий переход включен в прямом направлении.
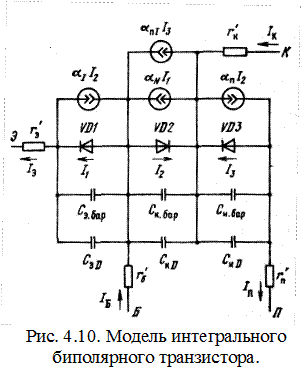 Взаимодействие переходов транзистора учитывается четырьмя генераторами тока. Генератор тока
Взаимодействие переходов транзистора учитывается четырьмя генераторами тока. Генератор тока  , включенный параллельно диоду VD2,учитывает передачу тока из эмиттера в коллектор, а генератор тока
, включенный параллельно диоду VD2,учитывает передачу тока из эмиттера в коллектор, а генератор тока  – из подложки в коллектор. Здесь
– из подложки в коллектор. Здесь  – инверсный коэффициент передачи паразитного p-n-p транзистора. Генератор тока
– инверсный коэффициент передачи паразитного p-n-p транзистора. Генератор тока  , шунтирующий диод VD1,определяет передачу тока из коллектора в эмиттер, а генератор тока
, шунтирующий диод VD1,определяет передачу тока из коллектора в эмиттер, а генератор тока  , включенный параллельно диоду VD3,–из базы в подложку (
, включенный параллельно диоду VD3,–из базы в подложку ( – нормальный коэффициент передачи паразитного транзистора).
– нормальный коэффициент передачи паразитного транзистора).
Статические параметры модели – тепловые обратные токи переходов и коэффициенты передачи тока связаны между собой двумя соотношениями:  =
=  и
и  =
=  . Таким образом, из семи перечисленных параметров независимыми являются пять.
. Таким образом, из семи перечисленных параметров независимыми являются пять.
|
|
|
Модель интегрального биполярного транзистора содержит четыре резистора:  ,
,  ,
,  и
и  , учитывающих влияние сопротивлений полупроводниковых областей эмиттера, базы, коллектора и подложки соответственно. Из-за резисторов напряжения на переходах
, учитывающих влияние сопротивлений полупроводниковых областей эмиттера, базы, коллектора и подложки соответственно. Из-за резисторов напряжения на переходах  ,
,  ,
,  отличаются от напряжений между соответствующими внешними выводами. Сопротивления перечисленных резисторов являются параметрами модели. Численно они могут отличаться от объемных сопротивлений соответствующих областей транзистора.
отличаются от напряжений между соответствующими внешними выводами. Сопротивления перечисленных резисторов являются параметрами модели. Численно они могут отличаться от объемных сопротивлений соответствующих областей транзистора.
Модель включает также барьерные и диффузионные емкости переходов: эмиттерного  , коллекторного
, коллекторного  и изолирующего
и изолирующего  , что позволяет использовать ее для анализа работы транзистора в импульсном режиме. Барьерные и диффузионные емкости зависят от напряжений
, что позволяет использовать ее для анализа работы транзистора в импульсном режиме. Барьерные и диффузионные емкости зависят от напряжений  ,
,  ,
,  . Поэтому в модели могут использоваться усредненные постоянные значения емкостей – тогда они являются параметрами модели. Для повышения точности модели могут производиться различные аппроксимации зависимостей
. Поэтому в модели могут использоваться усредненные постоянные значения емкостей – тогда они являются параметрами модели. Для повышения точности модели могут производиться различные аппроксимации зависимостей  и
и  . В этом случае заметно возрастает количество параметров модели, которые необходимо измерить. Например, зависимость барьерной емкости от напряжения на данном переходе обычно аппроксимируют функцией
. В этом случае заметно возрастает количество параметров модели, которые необходимо измерить. Например, зависимость барьерной емкости от напряжения на данном переходе обычно аппроксимируют функцией  , имеющей три параметра:
, имеющей три параметра:  – емкость при нулевом напряжении на переходе;
– емкость при нулевом напряжении на переходе;  – контактная разность потенциалов перехода;
– контактная разность потенциалов перехода;  – безразмерный коэффициент, лежащий в пределах от 1/3 до 1/2. Диффузионные емкости, существенные лишь при прямых напряжениях на переходах, представляют функциями вида
– безразмерный коэффициент, лежащий в пределах от 1/3 до 1/2. Диффузионные емкости, существенные лишь при прямых напряжениях на переходах, представляют функциями вида  .
.
Эта модель пригодна для анализа транзистора при большом сигнале, поскольку в ней учитываются нелинейные характеристики элементов (диодов и конденсаторов). Она применяется для расчета импульсных и цифровых микросхем.
Модель интегрального биполярного транзистора, представленную на рис. 4.10, можно несколько упростить, если учесть, что изолирующий переход всегда смещен в обратном направлении. Поэтому полагают  и
и  . Кроме того, обычно пренебрегают резистором
. Кроме того, обычно пренебрегают резистором  ,ввиду малости его сопротивления.
,ввиду малости его сопротивления.
|
|
|
Для расчета аналоговых микросхем используют малосигнальные модели транзистора, соответствующие активному режиму его работы, когда эмиттерный переход включен в прямом, а коллекторный – в обратном направлениях. От моделей для дискретных транзисторов они отличаются дополнительными конденсатором  , учитывающим барьерную емкость изолирующего перехода, генератором тока утечки этого перехода и резистором
, учитывающим барьерную емкость изолирующего перехода, генератором тока утечки этого перехода и резистором  .
.
ПОЛЕВЫЕ ТРАНЗИСТОРЫ
Полевые транзисторы с управляющим p-n-переходом. Полевые транзисторы (ПТ) хорошо вписываются в общую технологию биполярных ИС и потому часто изготавливаются совместно с биполярными транзисторами на одном кристалле. Типичные структуры ПТ с управляющим p-n-переходом, расположенные в изолированных карманах, показаны на рис. 4.11.
В структуре, показанной на рис. 4.11.а, р-слойзатвора образуется на этапе базовой диффузии, а n+-слои, обеспечивающие омический контакт с областями истока и стока, – на этапе эмиттерной диффузии. Заметим, что р-слой затвора окружает сток со всех сторон, так что ток между истоком и стоком может протекать только через управляемый канал.
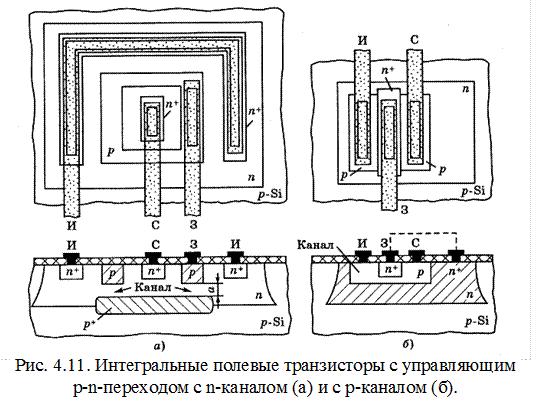
В n-карманах, предназначенных для ПТ, вместо скрытого n+-слоя осуществляется скрытый p+-слой. Назначение этого слоя — уменьшить начальную толщину канала а и тем самым напряжение отсечки. Осуществление скрытого p+-слоя связано с дополнительными технологическими операциями. Для того чтобы скрытый p+-слой проник в эпитаксиальный слой достаточно глубоко, в качестве акцепторного диффузанта используют элементы с большим коэффициентом диффузии (бор или галлий).
На подложку, а значит, и на p+-слойзадают постоянный (максимально отрицательный) потенциал; поэтому они не выполняют управляющих функций.
Структура, показанная на рис. 4.11.б,совпадает со структурой обычного n-p-n-транзистора. Роль канала играет участок базового р-слоя, расположенный между n+- и n-слоями. Если при совместном изготовлении ПТ и биполярного транзистора не использовать дополнительных технологических процессов, то толщина канала будет равна ширине базы n-p-n-транзистора (0,5-1 мкм). При такой малой толщине канала получаются большой разброс параметров ПТ и малое напряжение пробоя. Поэтому целесообразно пойти на усложнение технологического цикла, осуществляя р-слойПТ отдельно от базового р-слоя, с тем, чтобы толщина канала была не менее 1–2 мкм. Для этого проводят предварительную диффузию р-слояПТ до базовой диффузии. Тогда во время базовой диффузии р-слойПТ дополнительно расширяется, и его глубина оказывается несколько больше глубины базового слоя.
|
|
|
Для того чтобы области истока и стока соединялись только через канал, n+-слой делают более широким (в плане), чем р-слой (рис. 4.11.б).В результате n+-слой контактирует с эпитаксиальным n-слоем и вместе они образуют «верхний» и «нижний» затворы. В нижней части рис. 4.11.б контакт между «верхним» и «нижним» затворами условно показан штриховой линией. Подложка p-типа присоединяется к отрицательному максимальному потенциалу.
 МДП-транзисторы. Вообще говоря, совместное изготовление МДП- и биполярных транзисторов на одном кристалле, в едином технологическом цикле возможно, но является специальным случаем. Как правило, биполярные и МДП-транзисторные ИС разрабатываются и изготавливаются раздельно. Эти два типа ИС предназначены либо для решения разных функциональных задач, либо для решения одной и той же задачи, но с использованием преимуществ соответствующего класса транзисторов. Главную роль в современной микроэлектронике играют МДП-транзисторы, в которых диэлектриком является Si02, их называют МОП-транзисторами.
МДП-транзисторы. Вообще говоря, совместное изготовление МДП- и биполярных транзисторов на одном кристалле, в едином технологическом цикле возможно, но является специальным случаем. Как правило, биполярные и МДП-транзисторные ИС разрабатываются и изготавливаются раздельно. Эти два типа ИС предназначены либо для решения разных функциональных задач, либо для решения одной и той же задачи, но с использованием преимуществ соответствующего класса транзисторов. Главную роль в современной микроэлектронике играют МДП-транзисторы, в которых диэлектриком является Si02, их называют МОП-транзисторами.
В случае изготовления на одной подложке МДП-транзисторов истоки и стоки смежных элементов (рис. 4.11) оказываются разделенными встречновключенными p-n-переходами и такая связь не столь губительна, как в биполярных элементах. Однако с ростом степени интеграции и «сближением» элементов, обратные токи разделительных p-n-переходов растут и принуждают разработчиков ИС искать способы изоляции не только биполярных, но и МДП элементов.
|
|
|
 Простейший МОП-транзистор. Поскольку интегральные МДП-транзисторы не нуждаются в изоляции, их структура внешне не отличается от структуры дискретных вариантов. На рис. 4.12 воспроизведена структура МОП-транзистора с индуцированным n-каналом. Отметим особенности этого транзистора как элемента ИС.
Простейший МОП-транзистор. Поскольку интегральные МДП-транзисторы не нуждаются в изоляции, их структура внешне не отличается от структуры дискретных вариантов. На рис. 4.12 воспроизведена структура МОП-транзистора с индуцированным n-каналом. Отметим особенности этого транзистора как элемента ИС.
Очевидна, прежде всего, технологическая простота МОП-транзистора по сравнению с биполярными: необходимы всего лишь один процесс диффузии и четыре процесса фотолитографии (под диффузию, под тонкий окисел, под омические контакты и под металлизацию). Технологическая простота обеспечивает меньший брак и меньшую стоимость.
Отсутствие изолирующих карманов способствует лучшему использованию площади кристалла, т.е. повышению степени интеграции элементов. Однако, с другой стороны, отсутствие изоляции делает подложку общим электродом для всех транзисторов. Это обстоятельство может привести к различию параметров у внешне идентичных транзисторов. Действительно, если на подложку задан постоянный потенциал, а истоки транзисторов имеют разные потенциалы (такое различие свойственно многим схемам), то будут разными и напряжения  между подложкой и истоками. Это равносильно различию пороговых напряжений МДП-транзисторов.
между подложкой и истоками. Это равносильно различию пороговых напряжений МДП-транзисторов.
Как известно, главным фактором, лимитирующим быстродействие МДП-транзисторов, обычно являются паразитные емкости. Металлическая разводка, используемая в ИС, гораздо компактнее проволочного монтажа, свойственного узлам и блокам, выполненным на дискретных компонентах. Поэтому паразитные емкости интегрального МОП-транзистора меньше, чем дискретного, а его быстродействие соответственно в несколько раз выше.
 В комплементарных МОП-транзисторных ИС (КМОП) на одном и том же кристалле необходимо изготовлять транзисторы обоих типов: с n- и с р-каналом. При этом один из типов транзисторов нужно размещать в специальном кармане. Например, если в качестве подложки используется p-кремний, то n-канальный транзистор можно осуществить непосредственно в подложке, а для p-канального транзистора потребуется карман с электронной проводимостью (рис. 4.13, а). Получение такого кармана в принципе несложно, но связано с дополнительными технологическими операциями (фотолитография, диффузия доноров и др.). Кроме того, затрудняется получение низкоомных p+-слоев в верхней (сильно легированной) части n-кармана. Другим способом изготовления КМОП-транзисторов на одной подложке является КНС технология. В этом случае на сапфировой подложке создаются «островки» кремния с собственной проводимостью, после чего в одних «островках» проводится диффузия донорной примеси и получаются n-канальные транзисторы, а в других – диффузия акцепторной примеси и получаются p-канальные транзисторы (рис. 4.13, б).Хотя количество технологических операций и в этом случае больше, чем при изготовлении транзисторов одного типа, зато отпадают трудности, связанные с получением низкоомных слоев истока и стока (см. выше).
В комплементарных МОП-транзисторных ИС (КМОП) на одном и том же кристалле необходимо изготовлять транзисторы обоих типов: с n- и с р-каналом. При этом один из типов транзисторов нужно размещать в специальном кармане. Например, если в качестве подложки используется p-кремний, то n-канальный транзистор можно осуществить непосредственно в подложке, а для p-канального транзистора потребуется карман с электронной проводимостью (рис. 4.13, а). Получение такого кармана в принципе несложно, но связано с дополнительными технологическими операциями (фотолитография, диффузия доноров и др.). Кроме того, затрудняется получение низкоомных p+-слоев в верхней (сильно легированной) части n-кармана. Другим способом изготовления КМОП-транзисторов на одной подложке является КНС технология. В этом случае на сапфировой подложке создаются «островки» кремния с собственной проводимостью, после чего в одних «островках» проводится диффузия донорной примеси и получаются n-канальные транзисторы, а в других – диффузия акцепторной примеси и получаются p-канальные транзисторы (рис. 4.13, б).Хотя количество технологических операций и в этом случае больше, чем при изготовлении транзисторов одного типа, зато отпадают трудности, связанные с получением низкоомных слоев истока и стока (см. выше).
|
|
|
В процессе развития микроэлектроники усовершенствование МОП-транзисторов происходило по двум главным направлениям: повышение быстродействия и снижение порогового напряжения. В основе последней тенденции лежало стремление снизить рабочие напряжения МОП-транзисторов и рассеиваемую ими мощность. Поскольку полная мощность кристалла ограничена, уменьшение мощности, рассеиваемой в одном транзисторе, способствует повышению степени интеграции, а уменьшение напряжений питания облегчает совместную работу МОП-транзисторных и низковольтных биполярных ИС без специальных согласующих элементов.
Способы повышения быстродействия. Повышение быстродействия МОП-транзисторов связано прежде всего с уменьшением емкостей перекрытия. Существенное (примерно на порядок) уменьшение емкостей перекрытия достигается при использовании технологии самосовмещенных затворов. Общая идея такой технологии состоит в том, что слои истока и стока осуществляются не до, а после создания затвора. При этом затвор используется в качестве маски при получении слоев истока и стока, а значит, края затвора и этих слоев будут совпадать, и перекрытие будет отсутствовать.
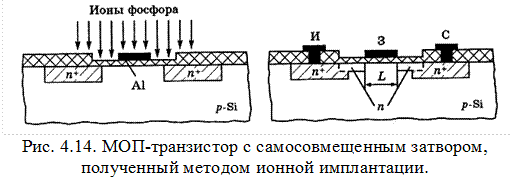
Один из вариантов МОП-транзистора с самосовмещенным затвором показан на рис. 4.14. Последовательность технологических операций при этом следующая. Сначала проводится диффузия n+-слоев, причем расстояние между ними делается заведомо больше желательной длины канала. Затем осуществляется тонкое окисление на участке между n+-слоями и частично над ними. Далее на тонкий окисел напыляется алюминиевый электрод затвора, причем его ширина меньше расстояния между n+-слоями. Наконец, проводится ионное легирование (имплантация атомов фосфора) через маску, образуемую алюминиевым затвором и толстым защитным окислом. Атомы фосфора проникают в кремний через тонкий окисел и «продлевают» n+-слои до края алюминиевой полоски так, что края затвора практически совпадают с краями истока и стока. Имплантированные слои легированы несколько слабее, чем диффузионные; поэтому для них использовано обозначение nвместо n+. Глубина имплантации также несколько меньше, чем глубина диффузии, и составляет 0,1-0,2 мкм.
Уменьшение паразитных емкостей МОП-транзисторов и, прежде всего емкости перекрытия  выдвигает на первый план задачу уменьшения постоянной времени крутизны
выдвигает на первый план задачу уменьшения постоянной времени крутизны  . При малых емкостях она становится главным фактором, ограничивающим быстродействие.
. При малых емкостях она становится главным фактором, ограничивающим быстродействие.
Переход от транзисторов с р-каналом к транзисторам с n-каналом позволил уменьшить значение  примерно в 3 раза благодаря увеличению подвижности носителей. Дальнейшее уменьшение величины
примерно в 3 раза благодаря увеличению подвижности носителей. Дальнейшее уменьшение величины  требует уменьшения длины канала
требует уменьшения длины канала  . При значениях
. При значениях  < 1 мкм (вместо 4-5 мкм у наиболее совершенных МОП-транзисторов, полученных по обычной технологии) постоянная времени
< 1 мкм (вместо 4-5 мкм у наиболее совершенных МОП-транзисторов, полученных по обычной технологии) постоянная времени  может быть менее 0,005 нс, а граничная частота
может быть менее 0,005 нс, а граничная частота  более 30 ГГц.
более 30 ГГц.
МНОП-транзистор. Особое место среди МДП-транзисторов занимает так называемый МНОП-транзистор, у которого диэлектрик имеет структуру «сэндвича», состоящего из слоев нитрида и окисла кремния (рис. 4.15, а). Слой окисла получается путем термического окисления и имеет толщину 2-5 нм, а слой нитрида – путем реактивного напыления и имеет толщину 0,05-0,1 мкм, достаточную для того, чтобы пробивное напряжение превышало 50-70 В.

Главная особенность МНОП-транзистора состоит в том, что его пороговое напряжение можно менять, подавая на затвор короткие (100 мкс) импульсы напряжения разной полярности, с большой амплитудой (30-50 В). Так, при подаче импульса + 30 В устанавливается пороговое напряжение U0 = - 4 В (рис. 4.15, б). Это значение сохраняется при дальнейшем использовании транзистора в режиме малых сигналов (U3 < ± 10 В); в таком режиме МНОП-транзистор ведет себя как обычный МДП-транзистор с индуцированным р-каналом. Если теперь подать импульс – 30 В, то пороговое напряжение сделается равным U0 = – 20 В и, следовательно, сигналы U3 < ± 10 В не смогут вывести транзистор из запертого состояния. Как видим, благодаря гистерезисной зависимости  МНОП-транзистор можно с помощью больших управляющих импульсов переводить из рабочего в запертое состояние и обратно. Эта возможность используется в интегральных запоминающих устройствах.
МНОП-транзистор можно с помощью больших управляющих импульсов переводить из рабочего в запертое состояние и обратно. Эта возможность используется в интегральных запоминающих устройствах.
В основе работы МНОП-транзистора лежит накопление заряда на границе нитридного и оксидного слоев. Это накопление есть результат неодинаковых токов проводимости в том и другом слоях. Процесс накопления описывается элементарным выражением  , где оба тока зависят от напряжения на затворе и меняются в процессе накопления заряда. При большом отрицательном напряжении на границе накапливается положительный заряд. Это равносильно введению доноров в диэлектрик и сопровождается увеличением отрицательного порогового напряжения. При большом положительном напряжении
, где оба тока зависят от напряжения на затворе и меняются в процессе накопления заряда. При большом отрицательном напряжении на границе накапливается положительный заряд. Это равносильно введению доноров в диэлектрик и сопровождается увеличением отрицательного порогового напряжения. При большом положительном напряжении  на границе накапливается отрицательный заряд. Это приводит к уменьшению отрицательного порогового напряжения.
на границе накапливается отрицательный заряд. Это приводит к уменьшению отрицательного порогового напряжения.
При малых напряжениях  токи в диэлектрических слоях уменьшаются на 10—15 порядков (!), так что накопленный заряд сохраняется в течение тысяч часов. Вместе с ним сохраняется и пороговое напряжение.
токи в диэлектрических слоях уменьшаются на 10—15 порядков (!), так что накопленный заряд сохраняется в течение тысяч часов. Вместе с ним сохраняется и пороговое напряжение.
ИНТЕГРАЛЬНЫЕ ДИОДЫ.
В качестве диода можно использовать любой из двух p-n-переходов, расположенных в изолирующем кармане: эмиттерный или коллекторный. Можно также использовать их комбинации. Поэтому по существу интегральный диод представляет собой диодное включение интегрального транзистора.
Пять возможных вариантов диодного включения транзистора показаны на рис. 4.16. В табл. 4.1 приведены типичные параметры этих вариантов. Для них приняты следующие обозначения: до черточки стоит обозначение анода, после черточки — катода; если два слоя соединены, их обозначения пишутся слитно. Из табл. 4.1 видно, что варианты различаются как по статическим, так и по динамическим параметрам.
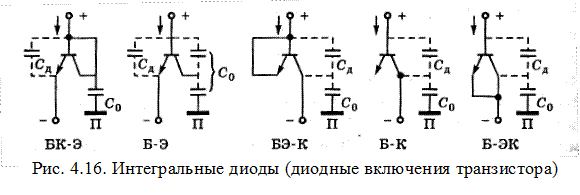
Пробивные напряжения  зависят от используемого перехода: они меньше у тех вариантов, в которых используется эмиттерный переход (см. табл. 7.2).
зависят от используемого перехода: они меньше у тех вариантов, в которых используется эмиттерный переход (см. табл. 7.2).
Обратные токи  (без учета токов утечки) — это токи термогенерации в переходах. Они зависят от объема перехода и, следовательно, меньше у тех вариантов, у которых используется только эмиттерный переход, имеющий наименьшую площадь.
(без учета токов утечки) — это токи термогенерации в переходах. Они зависят от объема перехода и, следовательно, меньше у тех вариантов, у которых используется только эмиттерный переход, имеющий наименьшую площадь.
Емкость диода  (т.е. емкость между анодом и катодом) зависит от площади используемых переходов; поэтому она максимальна при их параллельном соединении (вариант Б-ЭК). Паразитная емкость на подложку
(т.е. емкость между анодом и катодом) зависит от площади используемых переходов; поэтому она максимальна при их параллельном соединении (вариант Б-ЭК). Паразитная емкость на подложку  шунтирует на «землю» анод или катод диода (считается, что подложка заземлена). Емкость
шунтирует на «землю» анод или катод диода (считается, что подложка заземлена). Емкость  , как правило, совпадает с емкостью
, как правило, совпадает с емкостью  , с которой мы встретились при рассмотрении n-p-n-транзистора (рис. 4.13, б ). Однако у варианта Б-Э емкости
, с которой мы встретились при рассмотрении n-p-n-транзистора (рис. 4.13, б ). Однако у варианта Б-Э емкости  и
и  оказываются включенными последовательно и результирующая емкость
оказываются включенными последовательно и результирующая емкость  минимальна.
минимальна.
Время восстановления обратного тока  (т.е. время переключения диода из открытого в закрытое состояние) минимально у варианта БК-Э; у этого варианта заряд накапливается только в базовом слое (так как коллекторный переход закорочен). У других вариантов заряд накапливается не только в базе, но и в коллекторе, так что для рассасывания заряда требуется большее время.
(т.е. время переключения диода из открытого в закрытое состояние) минимально у варианта БК-Э; у этого варианта заряд накапливается только в базовом слое (так как коллекторный переход закорочен). У других вариантов заряд накапливается не только в базе, но и в коллекторе, так что для рассасывания заряда требуется большее время.
Таблица 4.1. Типичные параметры интегральных диодов
| Параметр | Тип диода | ||||
| БК-Э | Б-Э | БЭ-К | Б-К | Б-ЭК | |

| 7-8 | 7-8 | 40-50 | 40-50 | 7-8 |

| 0,5-1 | 0,5-1 | 15-30 | 15-30 | 20-40 |

| 0,5 | 0,5 | 0,7 | 0,7 | 1,2 |

| 1,2 | ||||

|
Сравнивая отдельные варианты, приходим к выводу, что в целом оптимальными вариантами являются БК—Э и Б—Э.Малые пробивные напряжения этих вариантов не играют существенной роли в низковольтных ИС. Чаще всего используется вариант БК-Э.
|
|
|


